半导体去胶技术——晶圆等离子去胶工艺,去除光刻胶、污染物、残余物和其他无用杂质
发布时间:2023-10-30 14:54:40
浏览数:2169
等离子去胶机在晶圆制造工艺中扮演着重要的角色。晶圆去胶是一个重要的步骤,它用于去除晶圆表面的胶层,以便进行后续的加工和制造步骤。
光刻胶(PR, Photo Resist)是半导体晶圆制造的核心材料,在晶圆制程中,光刻工艺约占整个晶圆制造成本的35%,耗时占整个晶圆工艺的40-50%。在光刻环节里有个不可或缺的步骤就是晶圆去胶,光刻胶去胶工艺在离子植入或刻蚀之后,晶圆表面剩余光刻胶和残余物需要通过去胶工艺进行完全清除。为了清除光刻胶、颗粒、污染物、残余物和其他无用材料,必须在制造过程中对硅片清洗,提高芯片成品率。
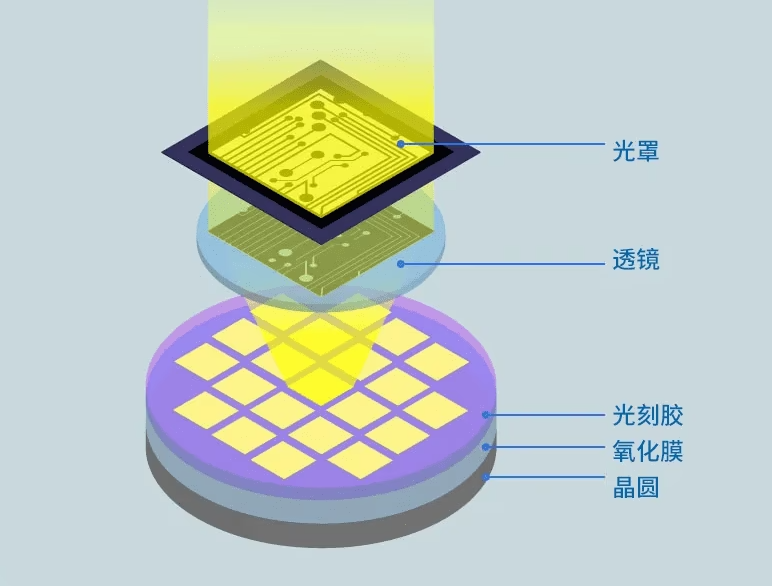
半导体光刻胶去除工艺,一般分成两种,湿法去胶和干法去胶。相对于湿法去胶,等离子干法去胶利用高能等离子体处理光刻胶表面,去胶彻底且速度快,不需引入化学物质,减少了对晶圆材料的腐蚀和损伤,是现有去胶工艺中最好,有效且高效的半导体光刻胶去除工具,具有高效、均匀、无损伤等特点。
等离子干式去胶工艺优势:
彻底去胶且速度快:等离子干法去胶利用高能等离子体处理光刻胶表面,去胶彻底且速度快。
无需引入化学物质:这种方法不需要引入化学物质,从而减少了对晶圆材料的腐蚀和损伤。
成品率高、工序简单、时间短:等离子体去胶法是一种干式法,具有成品率高、工序简单、时间短的优点。
操作较安全、重复性好:这种方法的操作较安全,重复性好。
无需进行废液处理:等离子体去胶法无需进行废液处理。
环保干净,清洗过程可控性非常强:等离子干刻机的去胶只需气体的参与,无需化学试剂的浸泡,无需烘干,整个处理环保干净,清洗过程可控性非常强。
降低成本,提高产品的良品率以及生产效率:这种工艺还能够降低成本,提高产品的良品率以及生产效率。
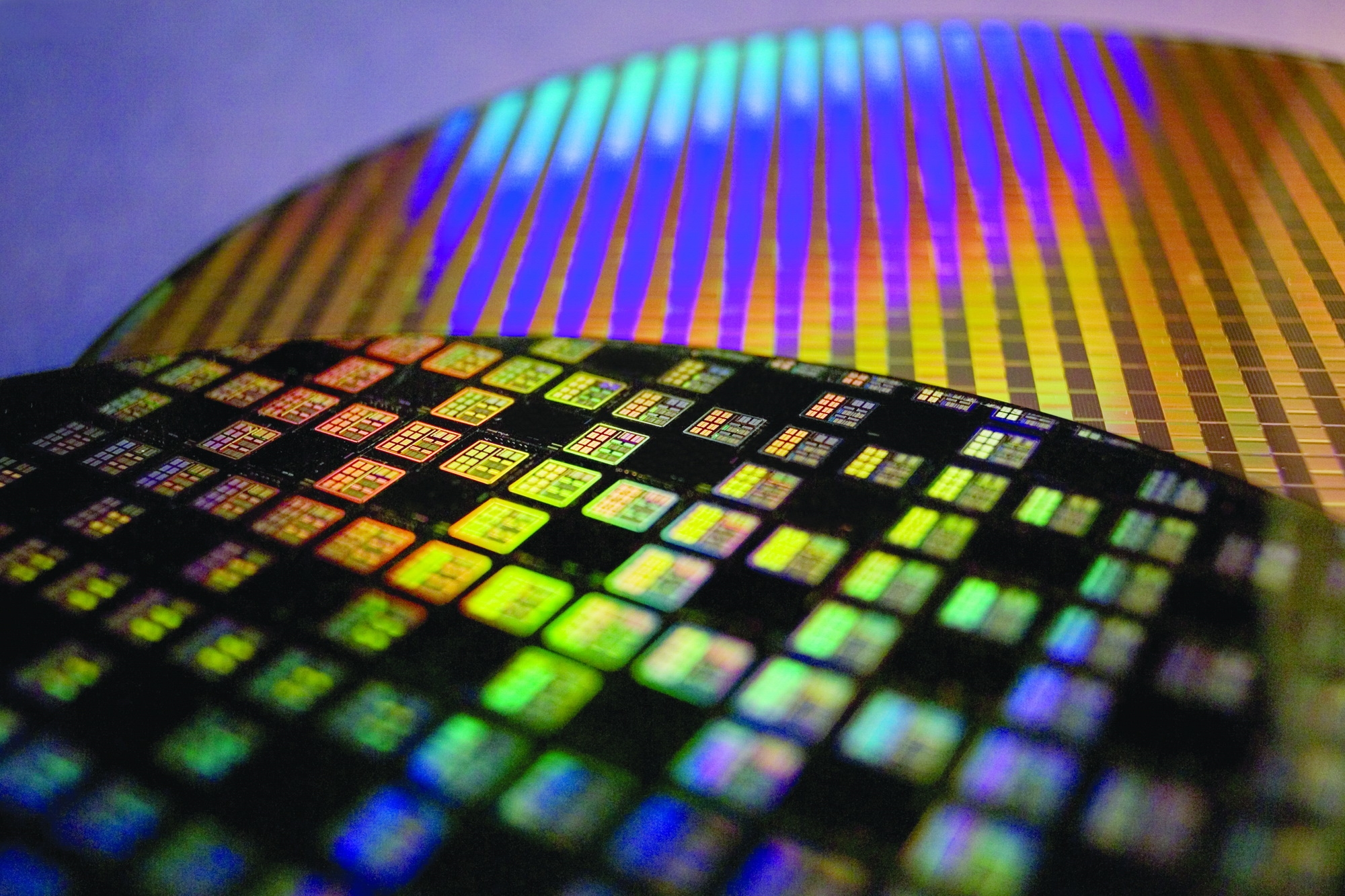
半导体晶圆:半导体单片扫胶、扫底膜工艺、元器件封装前、芯片制造等行业的重要清洗步骤。
硅基材料:硅基材料的晶圆表面去胶清洗。
砷化镓、氮化镓等:等离子去胶的工作原理是在真空状态下,使得气体产生活性等离子体,以此,在物理、化学双重作用下对清洗的部件如砷化镓、氮化镓等进行表面的轰击。
光刻胶:用于光刻胶去除。
碳化硅:用于碳化硅刻蚀。
硬掩膜层:用于硬掩膜层干法清除。
氧化硅或氮化硅:用于氧化硅或氮化硅刻蚀。








