 金属材料之间的粘接技术在航空航天、封装、建筑业、传感器等行业中广泛应用。尤其是在半导体封装设计中,为了提高半导体产品的可靠性和使用寿命,非常重视引线与基板之间键合的附着力。
金属材料之间的粘接技术在航空航天、封装、建筑业、传感器等行业中广泛应用。尤其是在半导体封装设计中,为了提高半导体产品的可靠性和使用寿命,非常重视引线与基板之间键合的附着力。
封装工艺通常可以分为前段操作和后段操作两大步,并以塑料封装成型作为前后段操作的分界点。通常情况下,芯片封装技术的基本工艺流程如下。第一步,硅片减薄,通过抛光、磨削、研磨以及腐蚀等达到减薄目的。第二步,晶圆切割,把制造的晶圆按设计要求分切成所需要的尺寸。第三步,芯片贴装,完成不同位置及各个型号尺寸芯片的贴片工艺。第四步,芯片互联,将芯片与各个引脚、I/O以及基板上布焊区等位置相连接,保证信号传输的流畅性和稳定性。第五步,成型技术,塑料封装,给芯片包覆外衣。第六步,去飞边毛刺,使外观更美观。第七步,切筋成型,按设计要求设计尺寸,将产品完成冲切分离,引脚打完成型,为后续工序提供半成品。第八步,上焊锡打码工序,注明产品规格和制造商等,注明其身份信息。
在现阶段封装技术的基本工艺流程中,硅片的减薄技术主要有磨削、研磨、化学机械抛光、干式抛光、电化学腐蚀、等离子增强化学腐蚀、湿法腐蚀以及常压等离子腐蚀等。芯片贴装的方式主要有共晶贴片、导电胶贴片、焊接贴片以及玻璃胶贴片4种。芯片互连常见的方法主要有打线键合、载在自动键合(TapeAutomateBonding,TAB)以及倒装芯片键合。封装工艺的好坏直接影响微电子产品的良品率,而在整个封装工艺环节中的最大问题是产品表面附着的污染物。针对污染物出现环节的不同,等离子清洗可应用于各个工序前边。它一般分布于粘片前、引线键合前以及塑封前等。
等离子清洗
等离子体是在胶体内包括足够多的正负电荷数量,且正负电荷数目相当的带电粒子的物质堆积状态,或者是由大量带电粒子组成的非凝聚系统。等离子体中包括正负电荷和亚稳态的分子和原子等。
一方面,当各种活性粒子与被清洗物体表面彼此碰触时,各种活性粒子与物体表面杂质污物会发生化学反应,形成易挥发性的气体等物质,随后易挥发性的物质会被真空泵吸走。例如,活性氧等离子体与材料表面的有机物发生氧化反应。它的优点是清洗过程相对较快、选择性相对好以及清除污染物的效果非常好,缺点是产品外表面发生氧化产生氧化物,附着在产品表面...








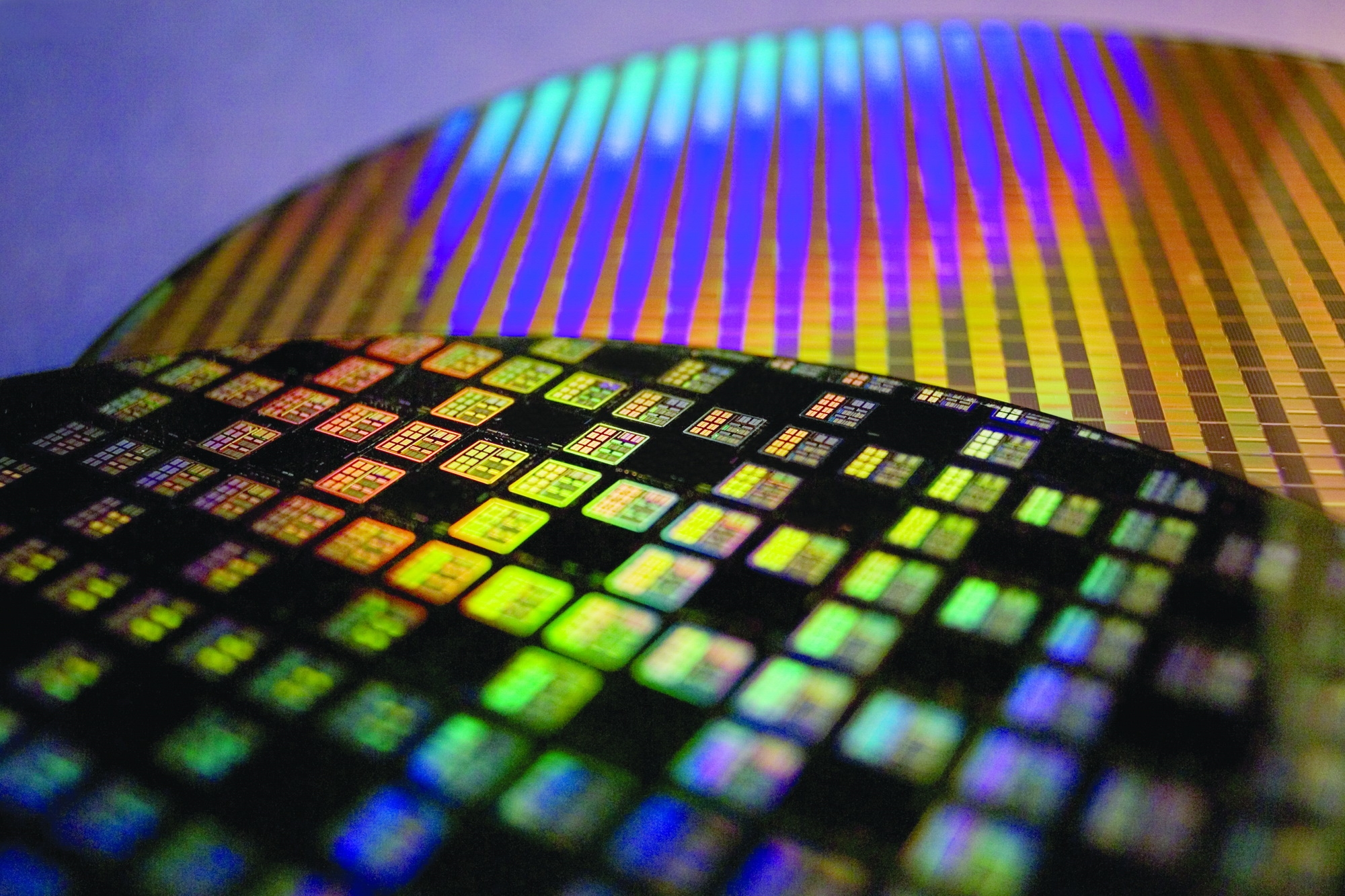
光伏刻蚀工艺亲水性.jpg)